荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
近日,SEMI在其发布的《全球半导体设备市场报告》中宣布,2022年全球半导体制造设备出货金额相较2021的1026亿美元增长5%,创下1076亿美元的历史新高。2022年中国大陆连续第三年成为全球最大的半导体设备市场,为283亿美元;中国台湾地区是第二大设备支出地区,2022年增长8%,达到268亿美元。韩国的设备销售额下降了14%,欧洲的年度半导体设备投资激增93%,北美增长了38%。
2022年,晶圆加工设备的全球销售额增长了8%,而其它前端领域的销售额增长了11%。在2021强劲增长后,封装设备销售额去年下降了19%,测试设备总销售额同比下降了4%。
芯片封装向制造环节靠近
在整个芯片制造的过程中,芯片封装是芯片成品至关重要的一步,在过去,封装定义为保护电路芯片免受周围环境的影响。随着芯片技术的不断发展,封装技术在提高芯片性能方面也开始扮演了重要的角色,越来越向芯片制造环节靠近。
封装不仅起着安装、固定、密封、保护芯片及增强电热性能等作用,而且还通过芯片上的接点用导线连接到封装外壳的管脚上,这些管脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。为配合系统产品多任务、小体积的发展趋势,集成电路封装技术的演进方向为:高密度、高脚位、薄型化、小型化。
据《中国半导体封装业的发展》报告,迄今为止全球芯片封装产业可分为五个发展阶段:元件插装、表面贴装、面积阵列封装、异质整合、3D堆叠。自第三阶段起的封装技术统称为先进封装技术。随着芯片产业的迅速发展,芯片间数据交换也在成倍增长,传统的芯片封装方式已经不能满足巨大的数据量处理需求。另外,随着“More Moore”技术路线逐步进入物理极限,制程工艺提升放缓,以3D堆叠封装为代表的先进封装技术将成为未来的重要发展方向。

后摩尔时代的机遇
随着云计算、网络、人工智能、自动驾驶、个人计算和游戏在内的高性能计算终端系统的增加,高性能封装市场也快速增长。相关调研报告显示,预计2027年该市场将超过145亿美元,高于2022年的26亿美元,2022到2027年间的CAGR为41%。
以上这些应用都需要用更复杂的节点生产更大、更复杂的芯片,这些节点会随着成本的增加而扩展。这些趋势促使半导体行业制定具有高端封装选项的系统级扩展策略,而不仅仅是扩展FE高级节点。

摩尔定律的延伸受到物理极限、巨额资金投入等多重压力,迫切需要别开蹊径推动技术进步。而通过先进封装可以相对轻松地实现芯片的高密度集成、体积的微型化和更低的成本,这使得台积电、英特尔、三星,以及主要封测代工厂商(OSAT)都对先进封装给予了高度重视,纷纷布局发展这方面的能力。
“目前我们重点发展几种类型的先进封装技术:首先是系统级封装(SiP),随着5G的部署加快,这类封装技术的应用范围将越来越广泛。其次是应用于Chiplet SiP的2.5D/3D封装,以及晶圆级封装,并且利用晶圆级技术在射频特性上的优势推进扇出型(Fan-Out)封装。此外,我们也在开发部分应用于汽车电子和大数据存储等发展较快的热门封装类型。”长电科技技术市场副总裁包旭升在接受媒体采访时如是表示。
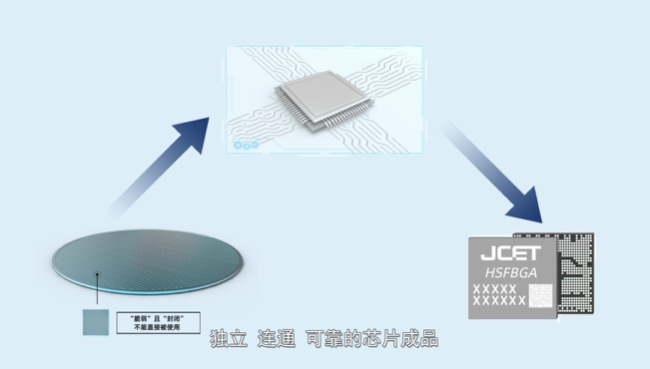
先进封装技术——SiP和3D封装
SiP是当前应用最为广泛的先进封装技术之一,是先进封装中带有系统功能的多芯片与器件的一种封装形式的总称。SiP可以将一颗或多颗芯片及被动元件整合在一个封装模块当中,从而实现具有完整功能的电路集成。这种封装方式可以降低成本,缩短上市时间,同时克服了芯片系统集成过程中面临的工艺兼容、信号混合、噪声干扰、电磁干扰等难题。
在后摩尔时代,随着芯片制程工艺逐渐逼近物理尺寸极限,3D封装技术正成为提升芯片集成度和性能的重要技术路线,这将推动半导体价值链向后道工艺移动。同时,3D封装技术对于芯片架构具有革命性的影响,这种影响将会传递到整个芯片产业链,并引起产业链中前道工艺和后道工艺协作机制的变化。
芯片3D封装技术,又称为叠层芯片封装技术,是指在不改动封装体尺寸的前提下,在一个封装体内的垂直方向叠放两个以上芯片的封装技术。近年来,支撑3D封装的关键技术硅通孔(Through Silicon Via,TSV)不断获得突破,国际芯片巨头加快布局,以TSV为核心的3D封装技术已成为业界公认的新一代封装技术的重要发展方向。
在3D封装技术路线的影响下,芯片设计将不再是单芯片设计问题,而是将逐渐演变成更为复杂的多芯片系统设计工程,还会对电子设计自动化(EDA)算法引擎提出更高的要求。
写在最后
未来,前段晶圆制造工艺与后段封装将很难清楚划分,晶圆厂也在做封装,如果封装企业只停留在封装阶段,不懂晶制造、不懂设计将无法适应未来的竞争形势。
目前,我国芯片产业发展迅速,封装技术发展接近国际先进水平,全球的封测行业已经基本上是美国、中国台湾和中国大陆三足鼎立的局面。未来,如何结合我国芯片封装产业优势,发力3D封装关键共性技术,以抢占机遇实现逆势突围,需要从政策层面到整个行业链上下游的共同努力!