荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
IDC预计,2025年中国AI芯片市场规模将达300亿美元,年复合增长率超过40%,前景广阔。SEMI也指出,AI芯片需求正推动2nm及以下先进工艺产能从2025至2028年保持14%的强劲复合年增长。
在此背景下,9月17日,由荣格工业传媒主办,半导体综研等友谊单位支持的“2025半导体制造工艺与材料论坛”在上海大宁福朋喜来登酒店成功举办。

本次论坛以“AI时代,从‘芯’开始”为主题,汇聚了产业链上下游企业与专家,围绕高端芯片、先进封装、AI良率提升等议题分享前沿成果、探索合作路径。
Part 1
开幕致辞

邵敏女士
荣格工业传媒会议部总监
会议伊始,荣格工业传媒会议部总监邵敏女士发表致辞。她表示,当前,全球半导体产业正处在技术迭代与格局重塑的关键阶段。地缘政治因素加剧了供应链的不确定性,材料与设备的自给率差距显著,“卡脖子”问题仍是行业共同面临的挑战。在此背景下,“AI赋能”与“先进封装”正成为突破瓶颈、重构生态的重要引擎,为产业注入全新动力。
机遇与挑战并存的当下,半导体产业迎来三大关键机遇:一是AI大模型爆发增长,催生对高算力、高密度芯片的迫切需求,推动先进封装与特种材料加速迭代;二是全球产业链布局调整,为区域协同创新与本土供应链建设创造空间;三是绿色制造理念深化,水资源循环与低功耗工艺等成为可持续发展必由之路。
但我们仍需正视诸多挑战,如光刻机等核心设备攻关难度大、高端材料国产化率低、跨领域协同机制尚未完善等,亟需全行业凝聚共识、携手突破。最后,她表示“通过今天的思维碰撞与经验交流,必将助力行业破解难题、把握机遇,共同推动半导体产业迈向更高质量、更可持续的未来。”。
Part 2
上午场

冉小飞 先生
艾欧资本( IO 资本)联合创始人、高级经理
艾欧资本(IO资本)联合创始人、高级经理冉小飞在《中国先进封装行业研究报告》主题报告中,聚焦中国先进封装行业,剖析其发展逻辑与前景。
主讲人表示,当下,先进封装发展呈现微型化与集成化两大趋势,从传统引线框架封装演进至晶圆级、立体结构封装。
市场层面,AI与后摩尔时代驱动行业增长:全球先进封装市场规模预计从2022年442.6亿美元增至2028年785.5亿美元,2.5D/3D技术以18.75%复合增速领跑。28nm以下高制程芯片依赖先进封装,Chiplet架构催生多片集成需求,附加值显著提升。

技术方面,TSV是2.5D/3D封装关键,2.5D通过硅中介层互连,3D则实现芯片直接高密度互连;3D Chiplet以无凸点垂直结构进一步提升集成度。头部玩家中,台积电、英特尔等海外厂商主导2.5D/3D技术,国内长电科技等在部分领域布局,但高端技术仍存差距。
AI大模型对算力芯片的高带宽、低延迟需求,叠加摩尔定律放缓,使先进封装成为提升芯片性能、降本增效的核心路径,行业迎来高速发展期。

张玉林 先生
威立雅水处理技术(上海)有限公司业务拓展经理
在《从“芯”开始:构建半导体制造水资源循环生态》报告中,威立雅水处理技术(上海)有限公司业务拓展经理张玉林聚焦水务技术在半导体领域的应用与价值作了核心分享。
作为全球领军的生态服务企业,威立雅以生态转型为立世之本,业务遍及56国,2024年营业额达446.92亿欧元,其水务板块为超1亿人提供饮用水服务,在华布局30余城及多个研发、制造基地。
针对半导体行业水资源挑战,威立雅提供全链条技术与服务:核心技术涵盖超滤、反渗透等纯水/超纯水制备,Actiflo®高效沉淀、EVALED™蒸发等废水处理与回用技术,搭配Sievers®分析仪等水质监测设备;服务覆盖中试、数字运维、移动水处理等全周期环节。

在可持续发展实践中,常熟树脂再生工厂为多行业提供稳定水处理支持;Actiflo®技术凭借占地小、效率高优势,在苏州、宜兴等地微电子项目中实现TSS高效去除与紧凑布局;EVALED™蒸发技术在光伏及半导体领域达成零液体排放、90%以上水回用率,显著降低处置成本。
威立雅通过技术创新与本地化服务,助力半导体企业破解用水难题,兼顾环境效益与运营效率,为行业水资源循环生态建设提供关键支撑。

张中 先生
副总经理
江苏芯德半导体科技有限公司
2.5D/3D封装被YOLE定义为超高端封装,市场前景广阔。YOLE预计2029年先进封装市场达695亿美元,超高端封装占276亿美元,年复合增长率约18%。
江苏芯德半导体科技有限公司副总经理张中在《高性能芯片高端互联技术以及芯德科技全方位解决方案》主题报告中,聚焦高性能芯片高端互联技术及解决方案,分享了超高端封装技术。
超高端封装具备重要战略意义:当前中国台湾地区垄断超高端封装技术与产能,美国正积极布局,台积电计划在美投建先进封装厂。发展该技术对中国产业布局至关重要。
2.5D封装作为核心超高端技术,以中介层连接芯片,搭配微凸块、TSV等技术,可实现多芯片高效互联,如NVIDIA A100便采用硅中介层连接GPU与HBM。3D封装则通过堆叠实现高密度集成。但行业面临挑战,集成电路封装材料超50类,仅10余类中低端实现国产化。

芯德科技以CAPiC为核心技术平台,提供2.5D/3D等超高端封装解决方案,覆盖从技术研发到应用落地的全链条,助力破解高速运算芯片互联难题。

方亮 先生
董秘兼战略发展总监
芯率智能科技(苏州)有限公司
在《次世代半导体技术的制程控制:芯率智能YMS方案赋能客户应对复杂集成电路的良率挑战》主题报告中,芯率智能科技(苏州)有限公司董秘兼战略发展总监方亮表示,当前CMOS 2.0时代与先进封装技术推动半导体复杂度飙升,良率观念发生转变,Chiplet综合良率依赖多颗die及封装工艺良率,且先进制程使量检测需求激增,面临研发周期缩短、工艺步骤增多、规格收紧等挑战。

为此,芯率智能推出AI+YMS方案,覆盖晶圆厂/中道工艺及先进封装全流程。其YMS平台整合全厂量检测机台数据,运用机器学习技术,定位缺陷产生的工艺环节与根本原因(root cause);在先进封装中,打通系统级封装全流程良率信息溯源;更以虚拟量测技术,基于AI预测缺陷密度,合理分配量检测资源,节约机台产能。以AI重塑芯片良率管理。
芯率智能主营AI+半导体良率管理系统(YMS),核心团队兼具IT与半导体技术背景,旗下子公司矩方信息、众壹云等长期服务华虹、中芯国际等企业,累计服务超15家大型晶圆厂/IDM。

杨尚勇 先生
资深总监
上海芯东来半导体有限公司
在《光刻机在先进封装领域的核心应用与关键挑战》主题报告中,上海芯东来半导体有限公司资深总监杨尚勇从封装演进与光刻的重要性展开,重点分享了光刻如何塑造先进封装、如何突破封装光刻瓶颈等内容。
主讲人介绍,先进封装(MCM、2.5D/3D)相较传统封装(TO/DIP、QFP/SOP、WB-BGA)主要有两大变化:
一是封装方式由Wire Bonding升级为Flip Chip,提高了一级封装的连接灵活性,并衍生出Bumping、回流焊、底部填充等工序;
二是2.5D/3D等立体封装对减薄/抛光提出更高要求,并新增RDL、Bumping、TSV等环节,提升集成度和技术难度,推动封装向高性能、高密度发展。
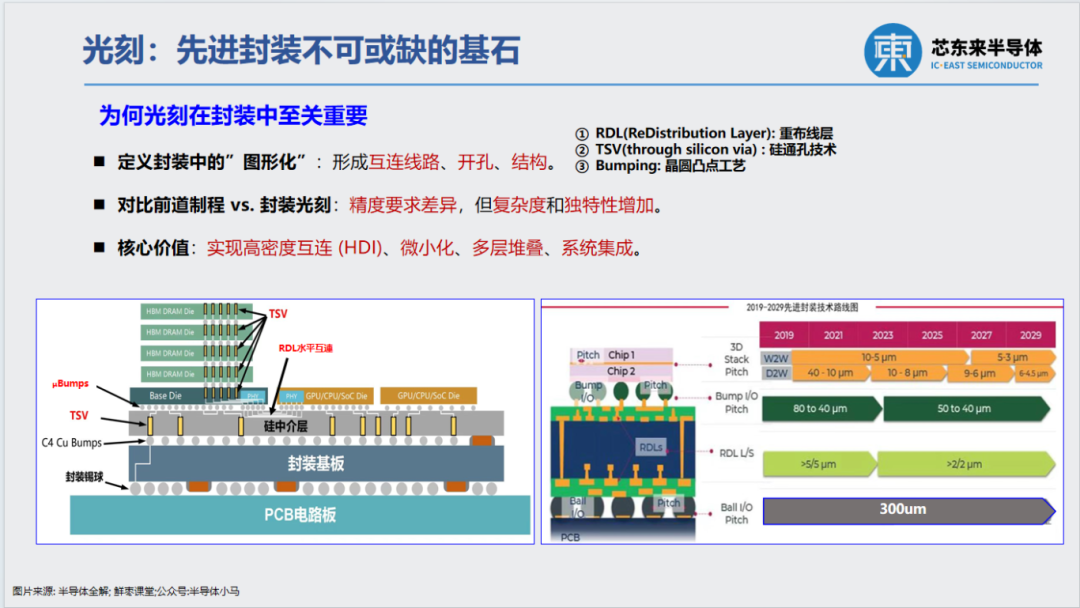
在此技术演变背景下,光刻在先进封装中的重要性凸显。同时,他还分享了当前封装光刻面临多重挑战:基板翘曲与大尺寸导致离焦,对准与套刻精度要求严苛,成本与良率平衡困难,混合键合等新技术提出更高标准。未来需向智能调平调焦、面板级光刻机、超高精度对准等方向突破。

黄清敏 博士
菲科半导体(张家港)有限公司总经理
PHT 株式会社代表取缔役社长
在当前中美半导体“强制脱钩”的宏观背景下,我国半导体产业链上下游如何在国际舞台上实现生存与立足,已成为国产半导体行业亟需应对的首要挑战。
菲科半导体(张家港)有限公司总经理兼PHT株式会社代表取缔役社长黄清敏博士,在题为《半导体材料企业国际化战略:携手日本设备制造商拓展海外市场》的主题报告中,分享了企业出海与国际化发展的实践经验。
PHT株式会社成立于2015年,总部位于日本东京,主营业务涵盖自动化搬运系统、晶圆清洗设备及微细精密加工,并在日本、美国和中国设立制造基地与服务中心,业务覆盖多个半导体细分市场。报告指出,公司核心战略是携手日本设备制造商共同开拓海外市场,合作模式包括联合研发、技术共享、培训与售后服务以及股权合作等;同时依托日本总部的业务功能,推动中国合作伙伴的材料产品实现国际交叉销售。
目前,公司已取得显著成果:累计交付设备超过400台,服务于多家行业头部客户,并荣获“海创杯”奖项;主导项目亦成功入围2025年第三届全国博士后创新创业大赛总决赛。其国际化发展路径聚焦多区域布局:在日本依托产业集群建设生产基地,在美国借助CHIPS法案落地产业园区以贴近客户,同时开拓亚洲及欧美市场,实现区域价值升级与全球战略延伸,从而提升企业竞争力并有效降低供应链风险。


Part 3
下午场

张轶铭 博士
北方华创微电子产品解决方案
北方华创微电子产品解决方案的张轶铭博士发表《北方华创助力异质异构集成应用》主题报告,他从AI芯片带动先进封装需求、GPU大规模应用推动封装技术迭代等行业趋势展开,探讨了高端芯片在先进封装中的关键工艺挑战,并分享了北方华创的设备解决方案。
主讲人表示,AI应用爆发推动人类进入“芯”纪元,但其对芯片“感、存、算、传”能力需求激增,且伴随巨大能源消耗,亟需更高效的集成电路技术突破。比如目前,高带宽存储HBM成为AI芯片的主流搭配,CoWoS已是重要的先进封装技术。

装备是工艺创新的核心支撑。工艺技术的进步不断对设备提出新要求、创新无止境。他阐述了优化设备与工艺流程对突破技术难点之间的关系,比如工艺优化升级边缘修正效应品质、高端芯片划片技术及工艺优化对产能的影响等等。
而北方华创以前道技术能力为依托,在三维集成方面提供以刻蚀、薄膜、炉管、清洗等四大类装备构建的2.5D/3D封装解决方案。主讲人详细介绍了这些设备产品,并特别强调了与产业界同仁合作推动大芯片未来发展的重要性。

吕芃浩 博士
战略分析总监
华封科技
随着集成度的提高,封装过程中的成本问题愈发显著。这主要是因为硅基中介层的成本高昂,而且堆叠性能越高,芯片数量越多,体积就越大,导致中介成本大幅上升。
华封科技战略分析总监吕芃浩博士发表《设备贴片:助力先进封装发展的关键力量》的主题报告,他从先进封装技术推动性能与成本效益提升等内容展开,对贴片机在封装技术中的关键作用以及贴片机效率与尺寸优化的发展趋势作了精彩分享。
他表示,设备通过模块化设计、多方位视觉检测、精准力控系统等技术升级,会满足日益复杂的工艺需求。其中,面板化将是先进封装贴片设备未来呈现的一个趋势。未来,先进贴片设备还将向智能化(AI故障诊断)、超高精密化(微米级定位)、绿色化方向突破,成为支撑先进封装产业发展的核心力量。
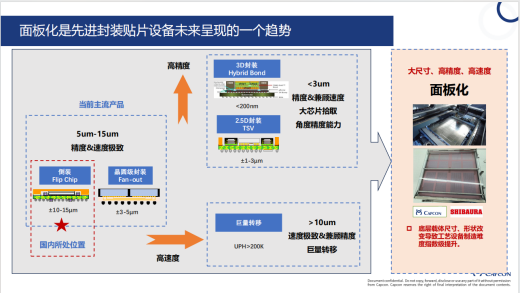
据介绍,华封科技通过前瞻性技术布局,已实现对先进封装全工艺场景的覆盖。华封科技始终保持技术研发领先于市场需求的节奏,这种前瞻性布局不仅助力企业实现从追赶到引领的跨越,更将为全球半导体产业的高质量发展注入持续动力。

李卫东 先生
CMO
锐杰微科技
结合行业需求、技术发展与公司产品解决方案等内容,锐杰微科技CMO李卫东发表《2.5D封装关键技术发展路径探讨》主题报告。
需求层面,AI算力爆发驱动市场增长,全球AI芯片、HBM、Chiplet市场规模均呈高增速,而高性能芯片面临存储墙、面积墙、功耗墙等挑战,先进封装成为突破路径,产业从器件微缩转向芯粒集成的变革路径。
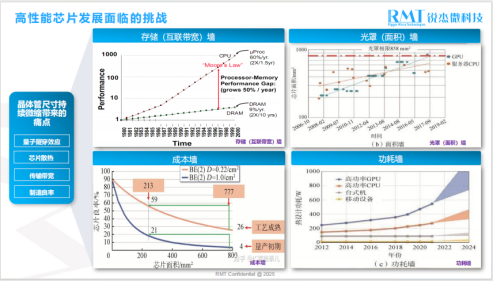
主讲人介绍,2.5D封装关键技术涵盖多维度,包括:计算架构向NUMA演进以降低内存延迟;存储端HBM技术持续升级,HBM4预计实现2458GB/s带宽;互联技术在各层级提升带宽与密度,芯粒互联IP规范多元发展;中介层技术呈现硅基、玻璃基等多样化形态;辅以eDTC电容、高层数基板及高效热管理技术应对性能与可靠性需求等。
锐杰微在封装仿真设计和成品制造领域提供一站式服务,其最新推出了包括设计全流程和工艺全流程在内的先进封装整体解决方案。现场,主讲人还分享了搭载HBM3的全国产2.5D AI芯片、超大尺寸MCM超算芯片等覆盖AI计算、网络交换等场景的公司案例。

贾李琛 先生
产品总监
南京宏泰半导体科技股份有限公司
随着高性能计算和人工智能的发展,先进封装测试市场规模不断扩大,但也面临诸多挑战,国产测试设备厂商迎来发展机遇。
南京宏泰半导体科技股份有限公司产品总监贾李琛在《国产测试设备在先进封装测试领域的机遇与挑战》主题报告中主要作了以下分享:
市场格局与趋势:高性能计算成为半导体主要需求驱动力,高端芯片市场增长迅速,人工智能芯片在先进封装市场占比不断提高。国际厂商在半导体测试机市场占据垄断地位,但测试成本在高端芯片成本中的占比越来越高,为国产设备提供了替代空间。

先进封装测试挑战:先进封装测试面临高PinCount与高功率密度、高速接口测试、跨SOC与Memory测试等多方面挑战。例如,芯片管脚数增多导致并行测试受限,高速接口测试成本高昂且国产设备速率较低,传统测试机无法满足跨芯片测试需求等。
宏泰科技应对策略:宏泰科技成立于2007年,提供半导体测试系统、自动测试分选系统等产品和服务。其ATE产品覆盖多种芯片类型,具备多时钟域、跨Memory与SOC测试等能力,分选机产品线也不断完善。

黄晓波 博士
技术市场总监
芯和半导体科技(上海)股份有限公司
在《多物理场仿真EDA赋能Chiplet先进封装设计》主题报告中,芯和半导体科技(上海)股份有限公司技术市场总监黄晓波博士从工具与生态建设、AI驱动行业趋势与技术挑战、EDA的创新实践以及产业链协同愿景等四个方面进行了具体分享。
在AI硬件对算力、存力、运力、电力的“四力”需求激增引起的连锁反应下,Chiplet先进封装成为突破瓶颈的关键方向,英伟达、AMD等企业均依托Chiplet打造AI基础设施方案,其集成正走向系统化与规模化,XPU/HBM Chiplet 交替升级成为AI芯片迭代主流。
而通过EDA技术桥梁作用,可以解决AI时代下算力、能效、互联三大矛盾,比如通过AI赋能自动化流程、设计左移策略、多物理场耦合应对等创新手段进行应对。芯和半导体提供一站式多物理场仿真EDA解决方案,已赋能多款HPC芯片及Chiplet集成设计,助力AI硬件高效迭代。
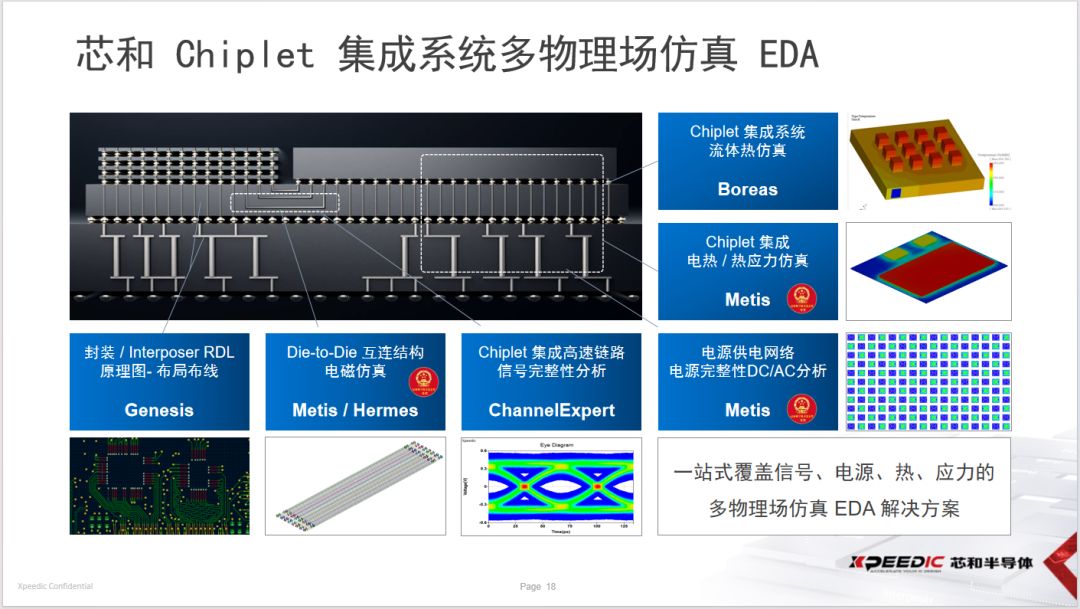
最后,主讲人倡导以系统级协同设计和跨领域生态合作应对挑战,最终服务于高端电子设备(如自动驾驶、智能手机、6G基站)的性能跃升。

张军明 先生
业务发展总监
飞潮(上海)新材料股份有限公司
飞潮(上海)新材料股份有限公司业务发展总监张军明发表《半导体过滤技术及产品分享》主题报告,他从Litho、WET、CMP、DEP等半导体过滤技术的应用展开,对过滤基础原理、半导体工艺中使用的各类产品,以及不同公司使用的技术节点等方面进行讲解。

主讲人重点阐述了直接拦截、吸附拦截和搭桥拦截三种过滤原理,并按照材质特性分类,对 PES、PP、PTFE等滤膜进行详细介绍。此外,他还分享了滤芯结构和筒式滤芯,以及其在气体过滤和液体化学药液处理中的应用。
比如滤芯主要应用于IC制造及上游材料、设备端,覆盖湿化学药液、CMP研磨液、光刻显影液及电子气体过滤等关键环节。飞潮成立20余年,拥有上海、无锡两大基地,可提供定制化过滤解决方案与技术支持。针对不同工艺需求,飞潮推出了适配高温强腐蚀性药液、用于光刻胶过滤以及适配CMP研磨液等专用产品。
在会议茶歇中,参会嘉宾们都参观、交流了哪些产品呢?

至此,荣格工业传媒主办的2025半导体制造工艺与材料论坛圆满结束!
如果您错过了这些精彩,
快来扫码注册,重温会议现场精彩演讲!

最后,再次感谢大力支持本届论坛的赞助商们以及支持单位、媒体单位,让我们下一届大会再相聚!

编辑 / Alec、Rachael

