荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。

先进封装市场的又一笔上市融资来了。近日,甬矽电子(688362.SH)11.65亿元可转债在上交所正式挂牌交易。其中的9 亿元将专项用于 “多维异构先进封装技术研发及产业化项目”。
其实,这并不是今年先进封装领域的第一笔上市融资。盛合晶微定向融资7亿美元(约合50亿人民币)推进2024年5月开工的超高密度三维多芯片互联集成加工项目;新恒汇于 6 月 11 日拟首发募资 5.19 亿元,用于高密度 QFN/DFN 封装材料产业化项目(4.56 亿元)和研发中心扩建升级项目。
在国产半导体公司积极IPO的当下,先进封装也获得不少资本青睐。2025年已经来到下半程,先进封装的市场主要呈现什么面貌?
在7月7日发布的《先进封装深度:应用领域、代表技术、市场空间、发展展望及相关公司深度梳理》报告中,,慧博智能投研给出了最新的观点,“全球集成电路月度销售额拐点出现,有望带动封装市场增长。未来,在新兴市场和半导体技术发展带动下,集成电路继续向着小型化、集成化、低功耗方向发展,附加值更高的先进封装将得到更多应用。”
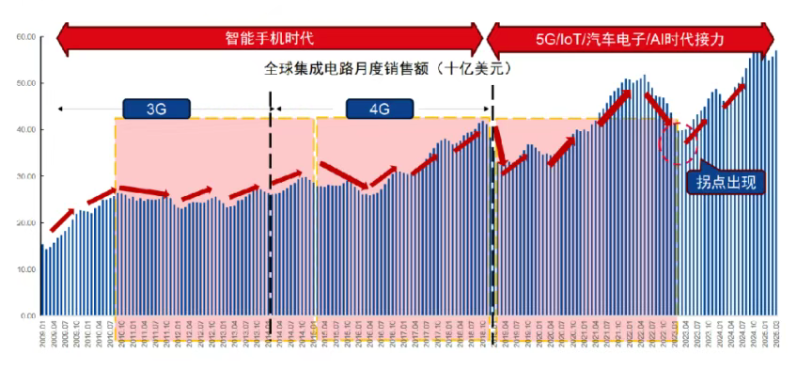
事实上,全球封装市场仍以海外厂商占主导,美国制裁倒逼先进封装加速国产化。Yole数据显示,2021年大陆厂商长电科技份额居全球第四,全球封装厂商Top10中,大陆厂商有长电科技、通富微电、华天科技三家,大部分比例份额仍由中国台湾、美国、韩国、日本厂商占据,大陆厂商全球份额仍有较大提升空间。

随着美国采取多种制裁措施限制大陆AI芯片发展,先进封装也将加速国产化。
从2021年至2025年上半年,据荣格电子芯片不完全统计,我国规模超10亿的先进封装投融资项目超数十个,投资总额近700亿元。单个项目的投资额不少超过百亿规模,多以通富微电、华天科技等龙头为主,这也侧面表明国产封测公司大力发展先进封装的决心。
以甬矽电子为例,其本次通过可转债项目布局多维异构先进封装技术,重点布局 2.5D/3D 先进封装领域。
多维异构封装技术是实现 Chiplet 的技术基石,其主要包括硅通孔技术(TSV)、扇出型封装(Fan-Out)、 2.5D/3D封装等核心技术。
该项目建成后,公司将开展“晶圆级重构封装技术(RWLP)”“多层布线连接技术(HCOS-OR)”“高铜柱连接技术(HCOS-OT)”“硅通孔连接板互联技术( HCOS-SI/AI)”等方向的研发及产业化, 并在完全达产后形成封测 Fan-out 系列和 2.5D/3D 系列等多维异构先进封装产品 9 万片/年的生产能力,拓宽公司在 AI、 HPC等高算力芯片领域的市场空间。
目前,甬矽电子的2.5D 封装已于2024年四季度完成通线,2025年5月正积极与客户进行产品验证。甬矽电子此番加码先进封装,既是应对国际竞争的必然选择,也是产业链向高端跃升的缩影。

图片来源 / 豆包
随着AI、HPC等新需求爆发,谁能率先突破技术瓶颈,谁就能在下一轮产业周期中占据主动。比如长鑫科技等在存储芯片技术上的创新,有望带动过程国产供应链在HBM等细分赛道分得一杯羹,这也将推动国产公司在先进封装技术的突破。
*声明:本文系荣格电子芯片综合整理,仅为传播信息所用,不构成任何投资依据;如对文章内容有异议,请联系后台。

