荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
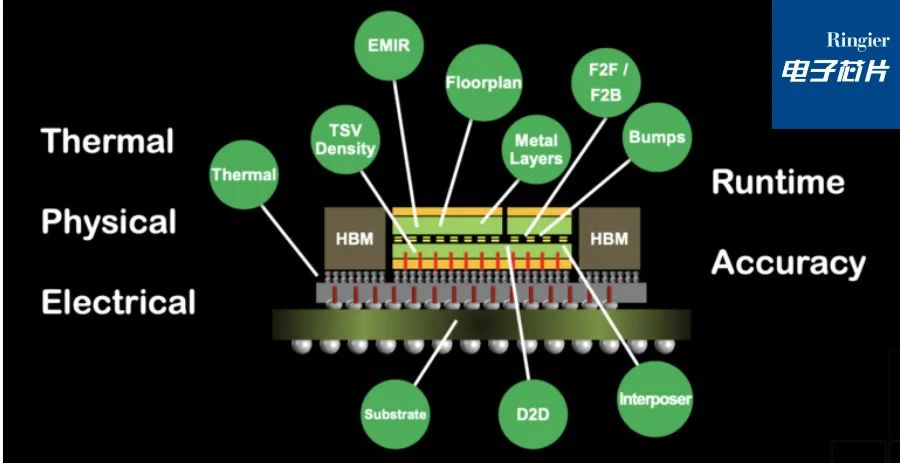
图片来源 / semiwiki
来源 / semiwiki;荣格电子芯片编译
作者 / Mike Gianfagna
台积电技术研讨会为台积电提供了一个全球舞台,以展示其先进的技术影响力和广泛的生态系统。台积电在其技术研讨会上涵盖了许多主题,包括业界领先的高性能计算、智能手机、物联网和汽车平台解决方案、5nm、4nm、3nm、2nm工艺、超低功耗、射频、嵌入式存储器、电源管理、传感器技术和人工智能支持。会议还讨论了产能扩张和绿色制造成就,以及台积电的开放式创新平台®生态系统。这些无疑是重大成就。
在这篇文章中,我想重点介绍先进封装方面的另一组重大成就。这项工作对半导体行业的未来具有重大意义。让我们来看看台积电先进封装如何克服多芯片设计的复杂性。
Part 1
为什么先进封装很重要
先进封装是纯晶圆代工模式中相对较新的补充。不久前,封装对于外包给第三方的芯片设计来说,还是一个不那么光鲜亮丽的表面处理要求。设计工作由封装工程师完成,他们将最终设计扔到墙上,以适应标准封装配置之一。
如今,封装工程师是设计团队的摇滚明星。这些人在设计之初就参与其中,并将奇特的材料和分析工具应用于项目。在封装工程师签字确认设计确实可以组装之前,该项目才是真实的。
随着设计过程的这一部分变得如此重要(和困难),台积电和其他代工厂挺身而出迎接挑战并将其作为所提供整体服务的一部分也就不足为奇了。所有这些变化的驱动力可以追溯到三个词:指数级复杂性增加。
多年来,摩尔定律以越来越大的单片芯片的形式实现了复杂性的指数级增长。如今,到达下一个工艺节点需要更多的努力和成本,而当您最终到达那里时,改进并不像以前那样显著。最重要的是,新设计的尺寸如此之大,以至于无法安装在单个芯片上。
这些趋势催化了复杂性呈指数级增长的新时代,这个时代依赖于单个封装中多个芯片(或小芯片)的异构集成,并且创造了先进封装作为关键使能技术的令人难以置信的关注和重要性。台积电在下图中很好地总结了这些趋势。

Part 2
台积电的先进封装技术
台积电提出了其战略的许多部分,以支持先进封装并开启异构集成的新时代。以下是台积电 3DFabric™ 技术组合的技术构建块:
●CoWoS®:Chip-on-Wafer-on-Substrate 是一种 2.5D 晶圆级多芯片封装技术,它将多个芯片并排集成在硅中介层上,以实现更好的互连密度和性能。单个芯片通过硅中介层上的微凸块键合,形成晶圆芯片 (CoW)。
●InFO:集成扇出晶圆级封装是一个晶圆级系统集成技术平台,具有高密度 RDL(再分布层)和 TIV(通过 InFO Via),可实现高密度互连和性能。InFO 平台提供各种 2D 和 3D 封装方案,这些方案针对特定应用进行了优化。
●TSMC-SoIC®:是一个服务平台,提供前端 3D 芯片间 (3D IC) 堆叠技术,用于重新集成从片上系统 (SoC) 分区的小芯片。由此产生的集成芯片在系统性能方面优于原始 SoC。它还提供了集成其他系统功能的灵活性。该平台与 CoWoS 和 InFO 完全兼容,提供强大的“3Dx3D”系统级解决方案。
下图总结了这些部分是如何组合在一起的。
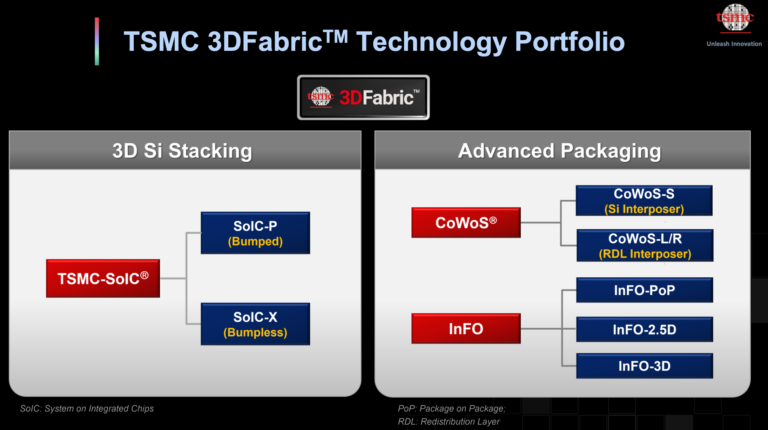
要让所有这些在整个生态系统中发挥作用,需要协作。为此,台积电成立了3DFabric联盟,与21个行业合作伙伴合作,涵盖内存、基板、测试和OSAT合作,以降低3DIC设计门槛,提高STCO并加速3DIC的采用。该团队还推动整个 3Dfabric 堆栈的工具、流程、IP 和互操作性方面的 3DIC 开发。下图总结了参与这项工作的组织组。

台积电在支持先进封装方面付出了很多努力。最后,我将举一个关于这项工作的例子。3Dblox™ 是一种标准的新语言,有助于使 3D IC 的设计变得更加容易。台积电与 Ansys、Cadence、Intel、Siemens 和 Synopsys 等 EDA 合作伙伴一起创建了 3Dblox,以将设计生态系统与台积电 3DFabric 技术的合格 EDA 工具和流程统一起来。下图显示了这一努力所取得的进展。

3Dblox路线图
原文链接:
https://semiwiki.com/semiconductor-manufacturers/tsmc/345909-tsmc-advanced-packaging-overcomes-the-complexities-of-multi-die-design/
*声明:本文系原作者创作。文章内容系其个人观点,我方转载仅为分享与讨论,不代表我方赞成或认同,如有异议,请联系后台。


