荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
2024年政府工作报告指出,中国新能源汽车,产销量占全球比重超过60%。快速增长的产业和市场青睐对汽车半导体产业提出了技术革新的紧迫需求。受车辆工况影响,车规级半导体需要在长时间、高负载和极端温度等挑战性环境中保持高可靠性,进而保障驾乘安全和舒适。
在今年的SEMICON China上,汉高粘合剂电子事业部带来了带来众多创新产品和解决方案,包括车规级高性能芯片粘接胶乐泰ABLESTIK ABP 6392TEA、毛细底部填充胶乐泰® Eccobond UF 9000AE,以及一系列先进封装材料、芯片粘接胶/膜解决方案等,以前沿材料科技助推半导体封装行业的高质量发展。展会现场,我们有幸采访到汉高粘合剂电子事业部亚太地区技术负责人倪克钒博士和半导体封装全球市场负责人Ram Trichur,听一听他们对于汽车半导体的未来发展有哪些观点,以及汉高未来在中国市场的布局又是怎样的。

汉高粘合剂电子事业部亚太地区技术负责人倪克钒博士(左);
半导体封装全球市场负责人Ram Trichur(右)
满足车规级芯片的可靠性要求
当前,智能化是汽车发展的一个重要趋势,而实现智能化有两个要素:传感器和信息处理。传感器可以帮助汽车更好地感知外面的世界,因此需要供应商不断升级产品以提供更有竞争力的传感器解决方案。随着汽车智能化发展,车内的传感器也越来越多,其中会涉及到芯片粘接、引线的包封、结构件的粘接等工艺,实现粘接的同时还要保证芯片良好的可靠性以及很好的应力控制。
此外,现在汽车在向集中式架构演进,可以更好地实现汽车智慧化的功能,封装形式也从原来比较传统的演变为先进封装模式。例如,在车规级半导体中,微控制器(MCU)扮演着关键角色,随着整车架构的发展,处理器的结构设计也会随之变化,先进封装也会更多引入其中以保证芯片的高可靠性。值得一提的是,MCU还必须符合高抗振性和耐热性要求。
汉高最新推出的乐泰ABLESTIK ABP 6392TEA是一款开创性的导电芯片粘接胶,适用于高可靠性MCU器件、完美适配QFP和QFN等其他高I/O封装。该产品具有对裸铜的强附着力、9.0W/m•K的良好导热率、低应力以及在8.0mmx8.0mm大尺寸芯片上的MSL 1高可靠性,在铜、银和PPF引线框架上也有着出色表现,能够满足性能与成本的双重需求。值得一提的是,该款产品目前已经在全球领先的芯片供应商的产品中有落地应用了。
此外,汉高还展示了具备超高导热率(165W/m•K)的无压烧结芯片粘接胶乐泰Ablestik ABP 8068TI,导电芯片粘接膜乐泰Ablestik CDF200/500等全面的产品组合,以助力高可靠性的汽车和工业功率半导体器件的发展。
据中国汽车工业协会最新数据,截至今年2月,我国新能源汽车产销累计完成125.2万辆和120.7万辆,同比分别增长28.2%和29.4%,市场占有率达到30%。新能源汽车三电系统相较于原来传统燃油车的动力系统也有很多不一样的地方——电动汽车需要很多大功率器件,碳化硅芯片的使用将越来越多。目前,碳化硅芯片主要应用在车用逆变器和高电压快充领域。
功率器件可以分成功率分立器件和功率模组,其对导热性、可靠性的要求更高。对于大功率芯片的粘接,汉高可以提供无压烧结和有压烧结的产品,并且在进一步开发例如铜烧结、银烧结等金属烧结工艺,满足更高的导热需求,适应新能源汽车设计的新趋势。
“车规级芯片与消费电子中芯片的最大区别在于对可靠性的要求更严苛,因为汽车的使用环境温度范围很广,而且长期在室外,工作时间更长,因此对于片封装材料的可靠性提出了更高的要求。”Ram表示道,“可靠性要求是车规半导体材料最高的指标。”
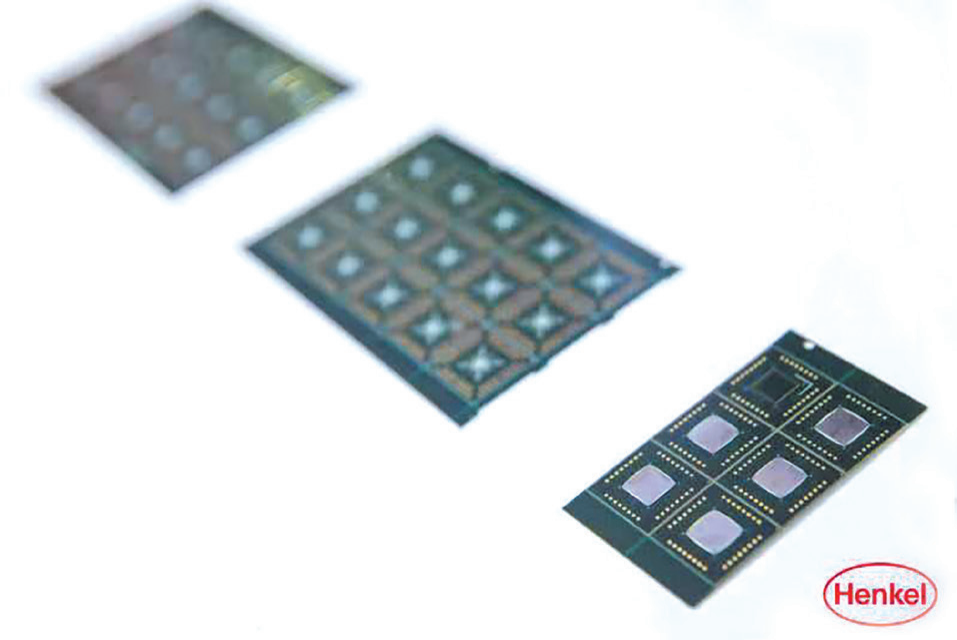
先进封装材料助力持AI产业发展
2024年初,以Sora和Claude 3为代表的生成式AI在世界范围内引发热烈讨论,同时也带来了更高的算力要求。由此,对于半导体产业来说,实现算力芯片组的封装和迭代升级成为迫在眉睫的挑战。
面对这些对算力要求极高的终端对先进封装工艺的要求,汉高推出了其最新的针对半导体大尺寸倒装芯片的毛细底部填充胶乐泰® Eccobond UF 9000AE。该产品能够提供刚性保护以抵御应力,从而提供良好的电气、湿度和热可靠性性能。
其低收缩和韧性为芯片提供良好的抗开裂性能,而其低热膨胀系数(CTE)可防止翘曲,提升产品良率。乐泰® Eccobond UF 9000AE出色的产品性能为高算力设备提供了坚实保障,助力人工智能、通信等高科技行业的半导体封装工艺不断突破。
同时,汉高还拥有一系列面向先进封装技术的产品组合,包括底部填充胶、盖板和加强圈粘接材料、液态压缩成型材料等,帮助客户解决在倒装芯片和堆叠封装设计、扇入扇出晶圆级封装(WLP)以及2.5D/3D集成架构中所面临的挑战,帮助产品实现确保长期可靠性、出色性能、高UPH和优秀作业性。
“消费类电子里面AI芯片主要是涉及到一些计算类芯片,其结构也会变得更加复杂,应用点也更加多变化。我们也会根据客户最终需求,紧密贴合他们变化的痛点,去帮助客户实现价值,进而实现我们的价值。”Ram如是说道。
值得一提的是,不同的应用场景选择的封装形式不一样,对产品本身需要可靠性的要求也会不一样,对于材料所需的性能也会不一样,导热性只是其中的一个维度。中低导热材料能覆盖90%以上的应用,像5G功率放大器、汽车功率器件除了需要更高的导热率,还需要有足够好的韧性,以承受在封装中所面临的应力。
“我们拥有广泛的产品组合:从10瓦以内主要是应用于模拟器件、MCU、传感器的低导热产品,到10~50瓦的中等导热产品,再到应用无压烧结工艺的50瓦以上的高导热产品,甚至200瓦以上应用有压烧结工艺的超高导热产品,我们都有覆盖。广泛的产品组合让我们可以在客户芯片设计的过程中跟他们有更好的配合,帮助他们达到可靠性要求,这也是值得汉高骄傲的地方。”倪克钒博士如是说道。
全球化布局,加大在华投资
电子产品的产业链覆盖从集成电路的设计、晶圆制造、半导体封装、模组到电路板组装,一直到终端设备。除了在集成电路设计和晶圆制造方面的材料汉高暂时还没涉及,在半导体封装、电路板组装等领域汉高有广泛的产品组合。
“电路板的组装工作其实运用了比人们想象得多得多的胶水,例如在一个手机中,可能就有超过50个的胶水应用点。”倪克钒博士分享道,“汉高的细分市场主要涉及半导体封装、模组和消费电子设备的组装,为这些工序提供相应的粘合剂技术。”
据倪克钒博士介绍,总部位于德国杜塞尔多夫的汉高在全球很多地方拥有研发中心跟生产基地,例如在2022年在德国杜塞尔多夫启动的粘合剂技术创新中心,在日本东京、韩国首尔和美国尔湾等地都有研发中心。 汉高粘合剂电子事业部在中国上海已经拥有三个创新中心。“作为一家全球性企业,汉高有着强大的研发和技术支持能力。同时,我们也立足本地,拥有本地研发能力和生产能力。”
在中国市场,汉高通过不断加大投资,持续提升自身在华研发与生产供应能力:2022年,位于电子产业集群腹地的汉高电子粘合剂华南应用技术中心启用,为客户提供及时的技术支持,强化与客户的合作,从而加速原型设计;2023年,投资约8.7亿元人民币的汉高鲲鹏工厂在烟台动工建设,该工厂将增强汉高在中国的高端粘合剂生产能力,并进一步优化供应网络,更好地满足国内外市场日益增长的需求。
“我们预计明年会在上海张江设立一座新的胶粘剂创新中心,它将让我们在中国有更好的本地研发和创新能力,能够满足中国客户在相关领域技术创新的需求。这将是一个新的里程碑。”倪克钒博士透露道,“汉高对中国以及亚太地区的业务发展有着长期承诺,推动中国半导体行业高质量发展也是我们一直所致力的方向。除了加大对创新技术的投资外,汉高还将持续提升本地化运营能力,并积极推动可持续发展,与中国半导体客户共同成长,为行业的蓬勃发展贡献力量,共创美好未来。”
谈及2024年汉高在电子制造行业的机遇,Ram认为,2024年的下半年会有非常显著的增长,增长点主要来自于汽车电子的庞大需求、数据中心与AI的迅猛发展以及消费类电子市场的复苏。我们也期待未来汉高能在半导体封装行业发挥更大的价值,推动行业往更高质量的方向发展!
来源:荣格-《国际汽车设计及制造》
原创声明:
本站所有原创内容未经允许,禁止任何网站、微信公众号等平台等机构转载、摘抄,否则荣格工业传媒保留追责权利。任何此前未经允许,已经转载本站原创文章的平台,请立即删除相关文章。

