荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
由于历史发展等种种原因,半导体电子芯片领域的技术及专利多聚集于国外。因此,这些在各个细分领域的领军企业具备先发优势,他们推出的新技术、新产品,向来是业内关注的重点。

半年季刚过,荣格电子芯片(微信号:RingierEC)梳理了1-6月国外巨头们在电子芯片领域的新技术、新产品,注意到以下现象:
技术研发多集中于制造及封测端,比如原材料、功率模块/器件、封装设计、检测等等。在本次删选的8家企业中,有关MOSFET的研究及产品最多,安世半导体扩充了NextPower 80/100 V MOSFET产品组合的封装系列,新增了规格;三菱电机开发出了集成SBD的SiC-MOSFET新型结构,以攻克芯片在高浪涌电流时热损坏的难题。
产业分工越细,技术迭代的发展是否就越快?至少在电子芯片领域,这个答案更倾向正面。比如杜邦针对当今的微凸块焊料电镀应用进行了优化,推出了一种高性能锡银焊料,它降低了沉淀风险,提高了络合组分的稳定性和槽液稳定性,从而延长了电镀液寿命。
“不积跬步,无以至千里”,电子芯片发展的质变,需要依靠产业链上各家企业一点一滴的技术进步、产品创新。而这种创新,正在随着新兴市场的不断涌现而提速。
以智能汽车为例,伴随智能化、电气化等的发展,AI逐步被应用于其中。联发科与英伟达正是从AI智能座舱入手布局。
这些新技术、新产品,尽管在目前还未成气候,但或许未来会成为新的高增长点。更多技术及产品如下:
注:按时间顺序排列
1.泛林集团推出针对3D芯片制造进行优化的斜角沉积解决方案
6月20日,泛林集团(Lam Research)推出新产品Coronus DX,它是业界首个经过优化的斜角沉积解决方案,旨在解决下一代逻辑、3D NAND和先进封装应用中的关键制造挑战。

随着半导体规模不断扩大,制造变得更加复杂和昂贵。在硅晶圆上构建纳米级器件需要数百个工艺步骤。Coronus DX只需一个步骤即可在晶圆边缘的两侧沉积一层专有的保护膜,这有助于防止先进生产过程中经常发生的损坏。这种强大的保护有助于推动更可预测的制造并显著提高产量,为采用迄今为止在商业上不可行的先进逻辑、封装和3D NAND生产工艺铺平了道路。
Coronus产品线于2007年首次推出,被各大半导体制造商使用,全球安装了数千个腔室。Coronus产品逐步提高了芯片制造商的晶圆产量,使每个蚀刻或沉积步骤的产量额外增加0.2%至0.5%。
2.安世半导体扩充MOSFET产品组合的封装系列
6月21日,Nexperia(安世半导体;闻泰科技为其控股股东)官微消息,宣布扩充NextPower 80/100 V MOSFET产品组合的封装系列。此前该产品组合仅提供LFPAK56E封装,而现在新增了LFPAK 56和LFPAK 88封装设计。这些器件具备高效率和低尖峰特性,适用于通信、服务器、工业、开关电源、快充、USB-PD和电机控制应用。

长期以来,品质因数Qg*RDSon一直是半导体制造商提高MOSFET开关效率的重点。然而,一味地降低该品质因数导致产生了意外后果,在打开或关闭MOSFET时尖峰耐压升高,从而使得产生的电磁干扰(EMI)增加。
确认这一新问题后,Nexperia(安世半导体)立即开始研究如何改善其他工艺技术参数,以帮助解决此问题。NextPower 80/100 V MOSFET的Qrr(反向恢复电荷)较低,因此可显著降低开关转换期间的尖峰值,同时表现出与竞品MOSFET相同的高效性能,且具有更低的EMI。
通过为高效率、低尖峰的NextPower 80/100 V MOSFET新增LFPAK56和LFPAK88封装系列,Nexperia(安世半导体)不仅可以帮助设计人员缩小应用尺寸并体验到铜夹片封装的超强可靠性,而且还为设计工程师和客户提供了新的选择,希望为现有设计提供额外的资源。
3.三菱电机成功开发基于新型结构的SiC-MOSFET
6月1日,三菱电机集团宣布,其开发出一种集成SBD的SiC-MOSFET新型结构,并已将其应用于3.3kV全SiC功率模块——FMF800DC-66BEW,适用于铁路、电力系统等大型工业设备。样品于5月31日开始发售。
与传统的芯片分开并联方法相比,集成了SiC-MOSFET和SiC-SBD的一体化芯片可以更紧凑地封装在功率模块内,从而实现功率模块的小型化、大容量和更低的开关损耗,有望在铁路、电力系统等大型工业设备中得到广泛应用。到目前为止,由于集成SBD的SiC-MOSFET功率模块的抗浪涌电流能力相对较低,浪涌电流只集中在某些特定的芯片上,导致芯片在高浪涌电流时热损坏,因此在实际应用中一直面临困难。
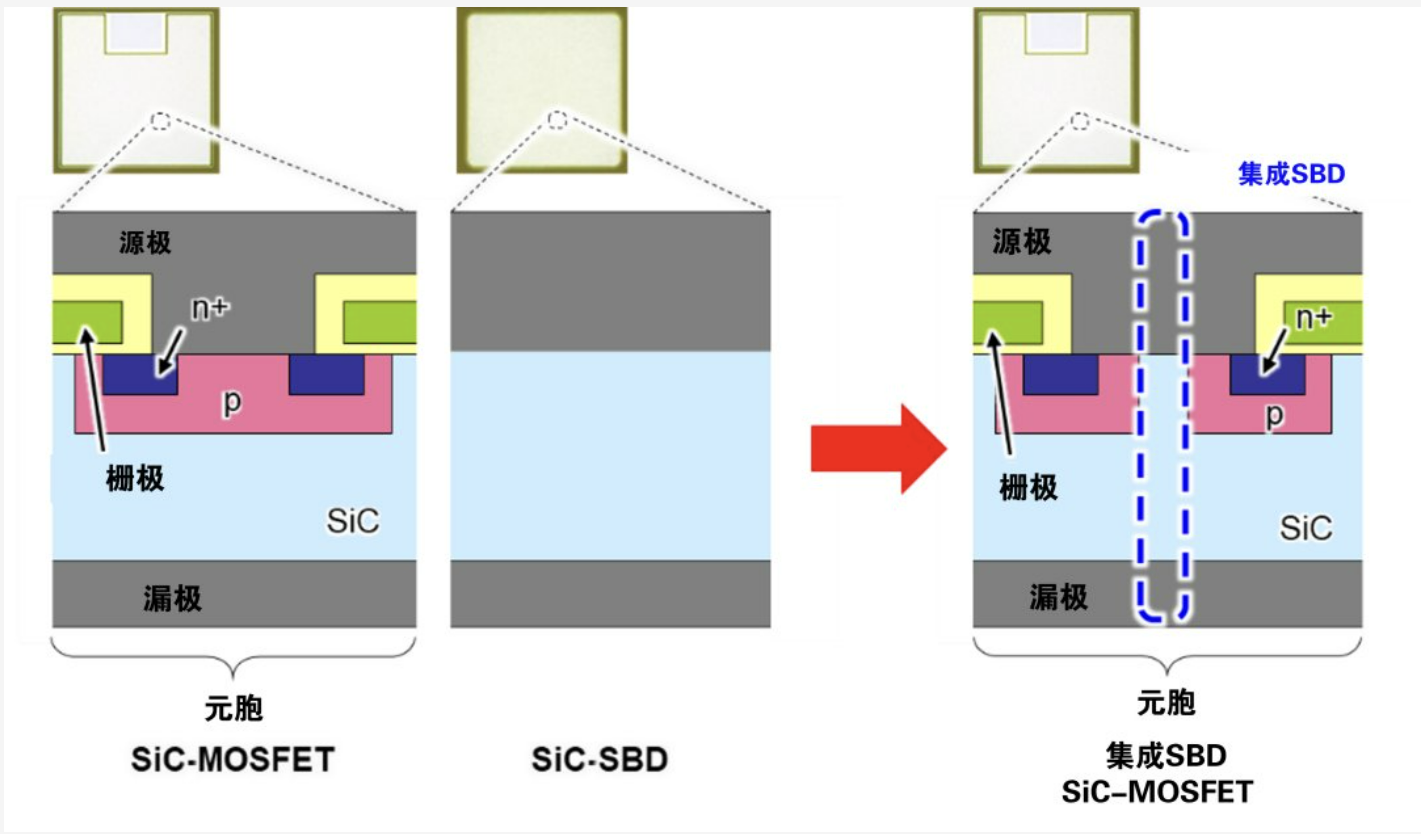
三菱电机率先发现了浪涌电流集中在功率模块内部某些特定芯片上的机理。开发了一种新的芯片结构,在这种芯片结构中,所有芯片同时开始通流,使浪涌电流分布在各个芯片上。因此,与本公司现有技术相比,功率模块的抗浪涌电流能力提高了五倍以上,获得了与现有Si功率模块同等或更高的浪涌电流耐量,从而实现了集成SBD的SiC-MOSFET功率模块。
4.西门子为扇出型晶圆级封装提供3D验证工作流程
5月31日,Siemens Digital Industries Software(西门子数字化工业软件)宣布已与领先的外包半导体组装和测试(OSAT)公司Siliconware Precision Industries Co.,Ltd.(SPIL)展开合作,为SPIL的先进IC封装技术扇出系列开发和实施新的集成电路(IC)封装组装规划和3D布局与原理图(LVS)组装验证工作流程。SPIL计划在其2.5D和扇出封装系列技术中部署这种差异化功能。
为了满足全球对IC在更小尺寸内提供更高性能和更低功耗的持续需求,IC设计越来越多地采用复杂的封装技术,例如2.5D和3D封装。这些技术将具有不同功能的一个或多个IC与增加的I/O和电路密度相结合,这反过来又需要能够创建和审查多个组件和LVS、连接性、几何形状和组件间距场景。

为帮助客户克服与部署这些先进封装技术相关的挑战,SPIL选择了西门子的Xpedition™Substrate Integrator软件和Calibre®3DSTACK软件用于其先进的扇出封装技术系列的封装规划和3D封装组装验证LVS。
5.杜邦推出晶圆凸块应用的锡银电镀液新产品
5月30日,杜邦电子与工业在IEEE电子元器件和技术大会上推出了DuPont™SOLDERON™BP TS 7000,这是锡银电镀化学品领域的最新创新。
DuPont™SOLDERON™BP TS 7000锡银电镀液是一种高性能锡银焊料,针对当今的微凸块焊料电镀应用进行了优化。利用杜邦在晶圆凸块应用电镀化学品方面的丰富经验,这种新型无铅电镀液将凸块共面性提高了20%以上,同时为微凸块和C4(可控坍塌芯片连接)应用提供更严格的银百分比控制和可靠的接头。该产品的另一个关键技术亮点是其出色的凸块共面性,可挑战同一芯片内的混合关键尺寸特征,这直接影响组装过程和可靠性。
此外,优化的添加剂体系降低了沉淀风险,提高了络合组分的稳定性和槽液稳定性,从而延长了电镀液寿命。事实证明,这种化学物质可在多次回流和反复热应力下保持出色的无空隙性能和机械完整性。
SOLDERON™BP TS 7000具有单一配方,足以适应各种尺寸和形状的凸块,包括直径从200微米到75微米不等的C4凸块到直径从100微米到10微米不等的铜柱盖。这消除了为微凸块和C4电镀更换电镀槽的需要,这些电镀槽服务于广泛的最终用途应用,包括高带宽存储器(HBM)。
6.联发科与英伟达携手合作AI智能座舱方案
5月29日,MediaTek(联发科技)宣布与NVIDIA(英伟达)合作,为软件定义汽车提供完整的AI智能座舱方案。通过此次合作,MediaTek将开发集成NVIDIA GPU芯粒(chiplet)的汽车SoC,搭载NVIDIA AI和图形计算IP。该芯粒支持互连技术,可实现芯粒间流畅且高速的互连互通。
MediaTek的智能座舱解决方案将运行NVIDIA DRIVE OS、DRIVE IX、CUDA和TensorRT软件技术,提供先进的图形计算、人工智能、功能安全和信息安全等全方位的AI智能座舱功能。
Dimensity Auto汽车平台承袭了MediaTek在移动计算、高速连接、多媒体娱乐等领域的专业技术积累,以及覆盖广泛的安卓生态系统,为用户提供全方位的沉浸式智能驾驶体验。结合NVIDIA在AI人工智能、云、图形技术和软件方面的核心专业优势,以及NVIDIA ADAS解决方案,MediaTek将进一步全面强化该汽车平台。
7.田中贵金属开发出用于半导体探针的新合金
5月16日,来自东京消息,田中贵金属工业株式会社宣布推出一种新合金“TK-FS”,用于半导体制造检查过程中使用的探针卡和测试插座的探针针脚。该产品的样品已从2022年7月开始发货,但持续的研究和开发已经产生了性能更高的材料。

新发布的TK-FS材料不仅可以用于pogo pin类型,还可以用于各种探针类型,包括用于晶圆测试(预处理)的悬臂式探针卡和垂直探针卡类型。该产品具有三大功能:维氏硬度500以上,电阻率7.0μΩ·cm以下,耐反复弯曲10次以上。与田中贵金属工业现有的探针材料相比,伸长率(8%~13%)更高。田中贵金属现有产品中没有一种材料可以同时实现高硬度、低电阻率和高柔韧性这三种功能,这使得它可以应用于各种类型的探针。

图探针材料特性比较(硬度/电阻率 20°C)

图 探针材料特性比较(伸长率)
田中贵金属的目标是到2028年将现有产品的出货量翻一番,并在未来将现有的大部分探针产品转移到TK-FS。
来源:荣格电子芯片综合报道整理。