荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
4月28日,荣格工业传媒主办的“2023先进封装技术论坛”成功举办。本次论坛聚焦芯片封装领域新材料、新技术、新工艺,一共邀请了4位嘉宾进行主题分享,他们分别来自厦门云天半导体科技有限公司、康模数尔软件技术(上海)有限公司(COMSOL中国)、上海复旦微电子集团、工业和信息化部电子第五研究所。
事实上,最新的调研数据显示,2020年至2026年,先进封装市场复合年增长率约为7.9%。到2025年,该市场营收就将突破420亿美元,是传统封装市场预期增长率2.2%的三倍。其中,2.5D/3D堆叠IC、嵌入式芯片封装和扇出型封装是增长最快的技术平台,复合年增长率分别为21%、18%和16%。
目前,在先进封装的市场争夺中,OSTA企业、晶圆代工厂、IDM、Fabless公司、EDA工具厂商等都加入其中,且斥资巨大。2.5D/3D封装、Chiplet、引线键合、晶圆级封装、硅通孔(TSV)等都备受关注。
那么,Chiplet等新型芯片集成封装如何设计并实现?2.5D/3D封装等工艺技术在实际操作中会遇到哪些难题?哪些应用市场端的潜力最大?围绕上述主题,4位企业代表、机构专家纷纷阐述了各自的观点。
扫码即可观看直播回放

5G光模块应用市场带来的危与机
据Yole统计,预计至2026年全球光模块市场规模达209亿美元,2020年全球光模块市场规模达96亿美元,其中电信市场43亿美元,占比45%;数通市场53亿美元,占比55%。2020-2026年的整体复合年增长率预计为14%;其中电信市场年复合增长率为5%,数通市场年复合增长率为19%。

在《光电器件集成封装技术》的主题演讲中,厦门云天半导体科技有限公司产品开发高级总监姜峰认为,光模块市场整体快速发展的同时,也给光电器件集成封装技术提出了新挑战,多芯片异质集成、微系统集成更加棘手,需要多种创新技术的综合运用。未来,光模块技术将往可热插拔、小型化、高速率、智能化、集成化等发展趋势演变。
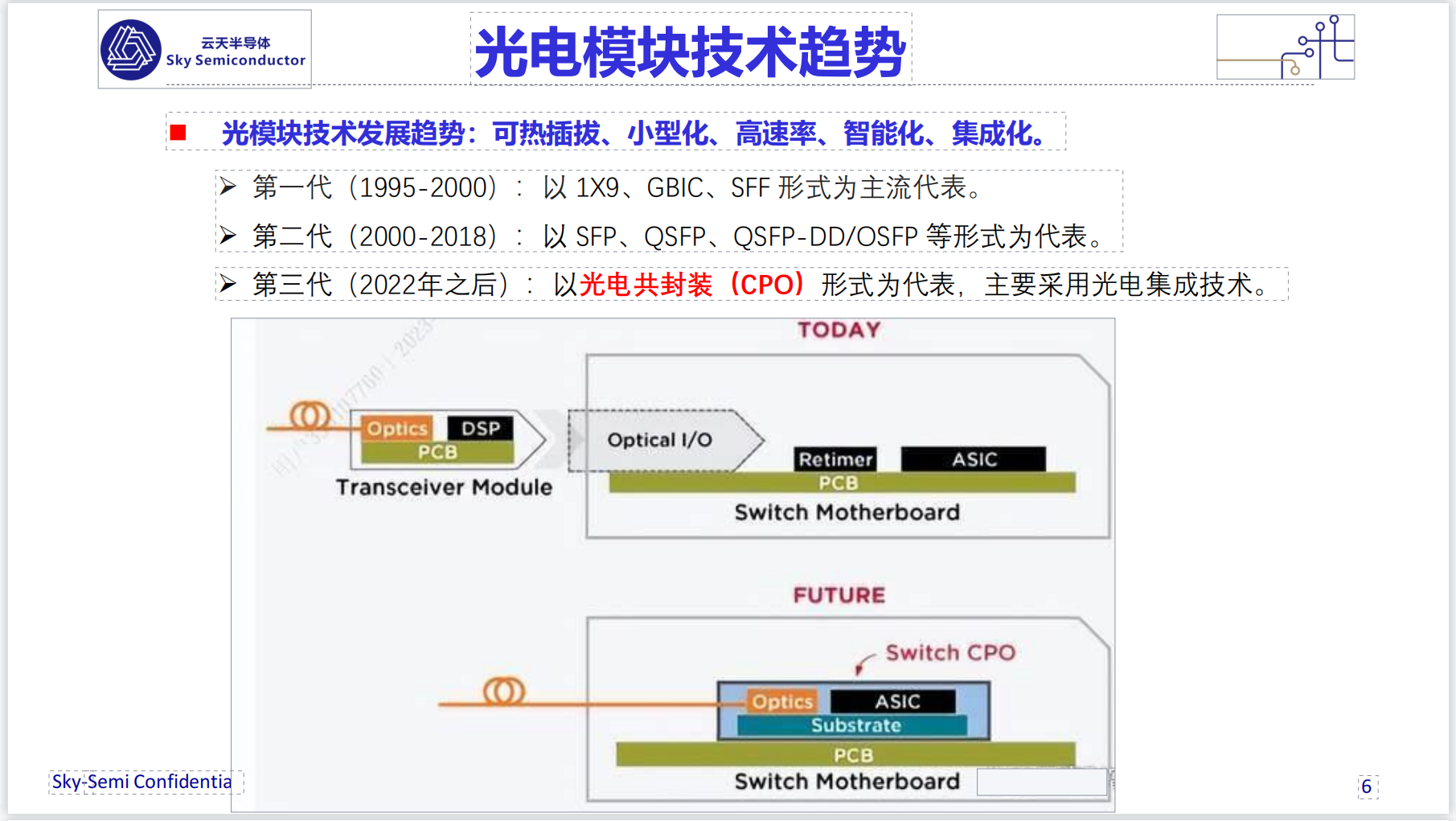
图片来源:嘉宾ppt
多物理场仿真助力先进封装
芯片小型化、集成化等让芯片制程尺寸越来越小,在这种纳米级的作业环境下,芯片内部的温度场、电磁场等等各种物理场,试验手段难以测量,而仿真正是一个非常好的替代解决方案。
在《多物理场仿真在半导体封装中的应用》的主题分享中,COMSOL中国资深应用工程师鲍伟向观众们介绍了在芯片封装中怎样实现多物理场耦合仿真,以及COMSOL软件在其中发挥的作用。他表示,在芯片的先进封装中,涉及到的温度场、电磁场、力学流体、声学等等都可以在COMSOL软件中进行仿真,参与物理场耦合的数量和类型没有任何限制。

由于实际器件工作在不同的环境下,芯片内部的多个物理场会互相产生作用和影响,如果要使用软件进行测量,主要包括先进封装低频电磁仿真、先进封装高频电磁仿真、场路耦合仿真、系统耦合仿真、电热耦合仿真、力学跨尺度耦合仿真等等。

图片来源:嘉宾ppt
新型芯片集成封装仿真难度大
随着芯片封装互连密度与复杂度越来越大,对封装电性能的要求越来越高。相对传统封装设计,新型芯片集成封装设计对信号完整性与电源完整性仿真分析、热性能仿真分析、机械结构仿真分析、多场耦合仿真分析的需求更加迫切,仿真难度更大。因此,重构封装互连工艺在芯片制造中的地位成为重要任务。

在《新型芯片集成封装的设计与实现》的主题分享中,上海复旦微电子集团副总经理,中国半导体行业协会集成电路设计分会副理事长沈磊博士从设计角度探讨了对芯片封装的要求。
他表示,起初,封装主要是给芯片起到热保护的作用,就像给它穿上一件衣服,与单芯片制造中,设计与封装的单工序独立模式不同,新型芯片集成如SIP、Chiplet等等需要多个方面的协调,如多物理场协同建模(热、力、电),多尺度联合仿真(从芯片到系统),芯片、封装、系统联合优化(多种数据格式交互)。这意味者,新型芯片集成封装设计不仅仅是互连设计、支撑保护设计,也更多的融入到了芯片架构设计之中。
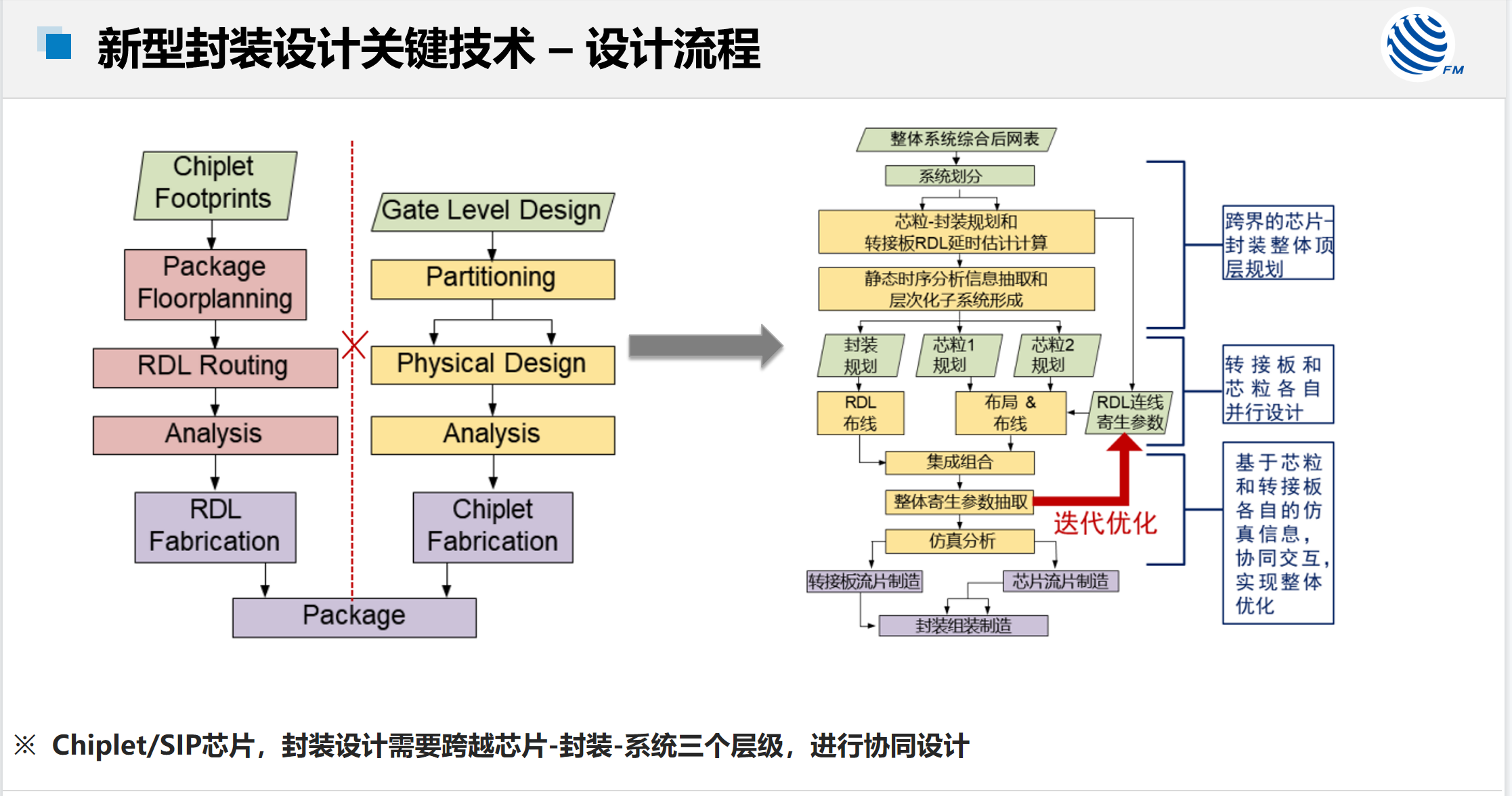
图片来源:嘉宾ppt
晶圆级三维集成标准体系亟待构建
针对上述需求,对晶圆厂来说,依据什么标准,并且怎样通过一套系统、科学的方式对晶圆级互连的工艺质量与可靠性,热、电可靠性等进行评价,显得尤为关键。来自工业和信息化部电子第五研究所的高级工程师陈思围绕上述主题进行了《晶圆级互连的工艺质量与可靠性评价方法》的精彩分享。

陈思介绍,在晶圆级工艺质量上,主要涉及两个方面:一是由于三维级电路设计、材料选型不合理常常会带来的电磁兼容、热聚集的问题。二是由于晶圆级互连工艺比较复杂,微纳工艺质量控制难度大,导致工艺缺陷多发,良率低下的问题。比如由于工艺控制不当引发的晶圆级三维集成失效模式,包括凸点的失效,TSV互连失效等等。
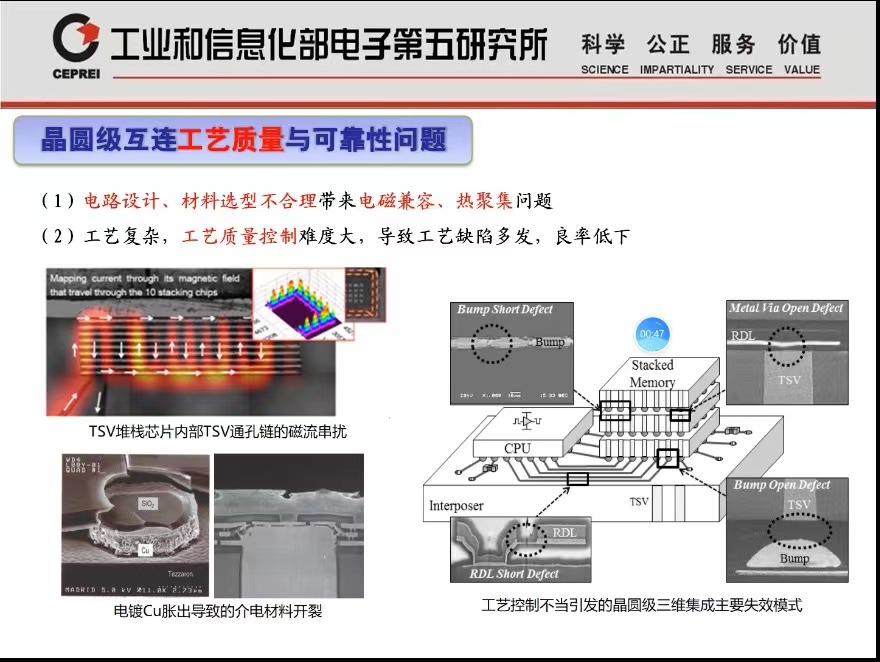
图片来源:嘉宾ppt
关于标准体系构建方面,陈思表示,国外已形成晶圆级三维集成关键技术标准体系,国内尚未形成针对于晶圆级三维集成的标准体系,多停留在利用现有的国标、国军标的标准草案,或零星行业标准,针对晶圆级三维集成的标准草案尚不具规模性和系统性。