荣格工业资源APP
了解工业圈,从荣格工业资源APP开始。
半导体生产需要复杂的制造工序,包括机械加工,光刻和化学处理等,加工过程中芯片均在由纯半导体材料制成的晶圆上制成,一般采用硅片,也可根据实际应用选用各种化合物半导体材料。FocalSpec® 3D 线共焦传感器为整个工艺中的各个阶段提供一站式的检测解决方案,实现卓越产品质量和优化产能。
晶圆尺寸、平面度和缺陷检测
晶圆根据指定特性被分为不同的级别。FocalSpec® 3D线共焦传感器可高速扫描和检测晶圆的尺寸,厚度和平面度,并完成高精度的缺陷检测。晶圆抛光垫对化学机械抛光(CMP)工艺中的平衡起着重要作用。抛光垫随着时间流逝会开始出现磨损,需要作为生产线机器监控维护协议的一环进行定期检查。FocalSpec® 3D线共焦传感器被应用于扫描晶圆垫表面,在3D高度图中识别出可能标志着磨损区域的变化值。
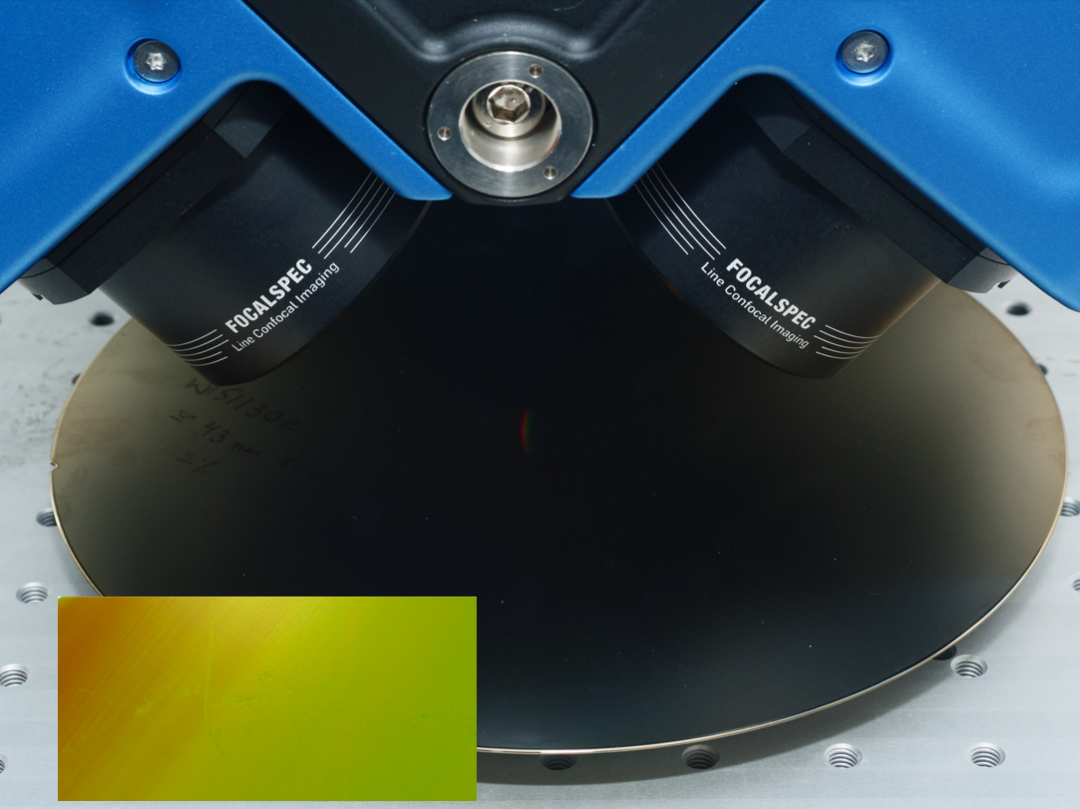
切割是一种晶粒单切技术,先通过加工工具(例如Saw Blade)对晶圆或基板进行部分切割,随后通过“切穿”工艺将晶圆沿着切割线彻底切开,将其分成一个个独立的Die。
激光划片/切割完成后,FocalSpec® 3D 线共焦传感器用于测量晶圆切割的凹槽精度,比如凹槽深度以及切缝宽度,同时预防晶圆崩边等缺陷的产生。从而使每个硅片制成更多可用的Die,并确保最高的质量和处理速度,以达到最高的产能。
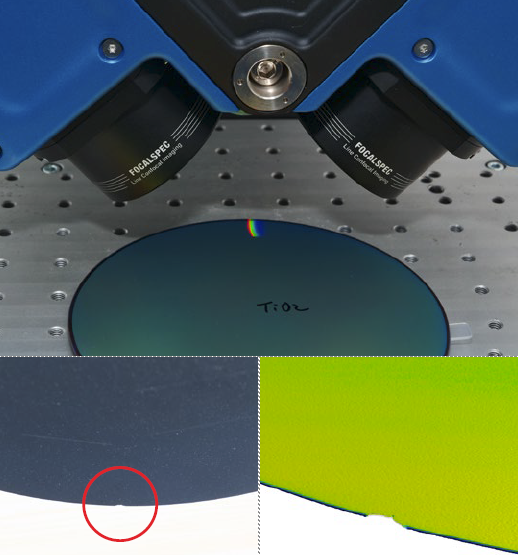
装配和IC测试阶段的BGA和PGA位置、高度和半径检测
BGA(球栅阵列式封装)芯片是采用表面贴装技术进行高密度连接的典型集成电路芯片。随着半导体生产中BGA引脚数的增加,引脚高度,直径,偏移和漏焊检测具有重要意义。使用FocalSpec® 3D线共焦传感器进行测量,获取球高,球径和球位置等尺寸信息,可检测直径低于50μm球体。
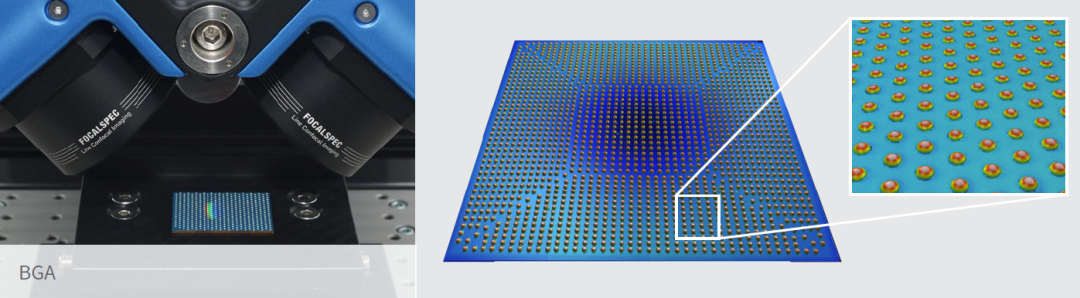
PGA(插针网格阵列封装)由这种技术封装的芯片内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列,根据管脚数目的多少,可以围成2~5圈。FocalSpec可精确检测PGA针脚高度以及位置度,确保后续插拔过程中不会接触不良,且规避因位置偏移导致针脚损坏等缺陷的发生。
PCB基板和BGA封装在热膨胀系数的差异会由于弯曲(热应力)或延展并振动,导致焊点断裂。FocalSpec® 3D线共焦传感器可在焊接前准确测量和检测接头位置的平面度和高度,减少后续焊接完成后焊点断裂的可能。
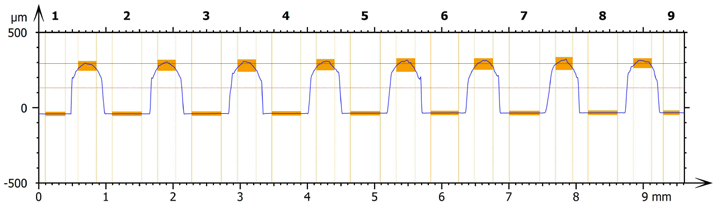

芯片粘接工艺中的银浆厚度和气泡缺陷检测
芯片粘合剂例如导电银浆,将芯片粘合到芯片承载,基板或模腔,还可在芯片和封装间实现导热和/或导电,这会在实际操作中会影响到设备性能。
Focalspec® 3D线共焦传感器可精确测量每个Lead frame区域中涂覆银浆的面积占比及银胶高度(即厚度),生成基本的3D形状数据,用于对胶路进行精确的体积测量和基于形状的缺陷检测,例如气泡以及厚度不良。另外,可用于扫描从不透明到半透明到透明的各种粘合剂。